底部填充胶是一种高流动性,高纯度的单组份环氧树脂灌封材料。能够通过创新型毛细作用在CSP和BGA芯片的底部进行填充,经加热固化后形成牢固的填充层,降低芯片与基板之间因热膨胀系数差异所造成的应力冲击,提高元器件结构强度和的可靠性,增强BGA 装模式的芯片和PCBA之间的抗跌落性能。
KY底部填充胶,在室温下即具有良好的流动性,填充间隙小,填充速度快,能在较低的加热温度下快速固化,可兼容大多数的无铅和无锡焊膏,可进行返修操作,具有优良的电气性能和机械性能。
二、底部填充胶应用原理:
底部填充胶的应用原理是利用毛细作用使得胶水迅速流过BGA 芯片底部芯片底部,其毛细流动的最小空间是10um。 这也符合了焊接工艺中焊盘和焊锡球之间的最低电气特性要求,因为胶水是不会流过低于4um的间隙,所以保障了焊接工艺的电气安全特性。
三、底部填充胶起什么作用:
随着手机、电脑等便携式电子产品,日趋薄型化、小型化、高性能化,IC封装也日趋小型化、高聚集化,CSP/BGA得到快速普及和应用,CSP/BGA的封装工艺操作要求也越来越高。底部填充胶的作用也越来越被看重。
BGA和CSP,是通过微细的锡球被固定在线路板上,如果受到冲击、弯折等外部作用力的影响,焊接部位容易发生断裂。而底部填充胶特点是:疾速活动,疾速固化,能够迅速浸透到BGA和CSP底部,具有优良的填充性能,固化之后可以起到缓和温度冲击及吸收内部应力,补强BGA与基板连接的作用,进而大大增强了连接的可信赖性.
举个例子,我们日常使用的手机,从2米高地方落地,开机仍然可以正常运作,对手机性能基本没有影响,只是外壳刮花了点。很神奇对不对?这就是因为应用了BGA底部填充胶,将BGA/CSP进行填充,让其更牢固的粘接在PBC板上。
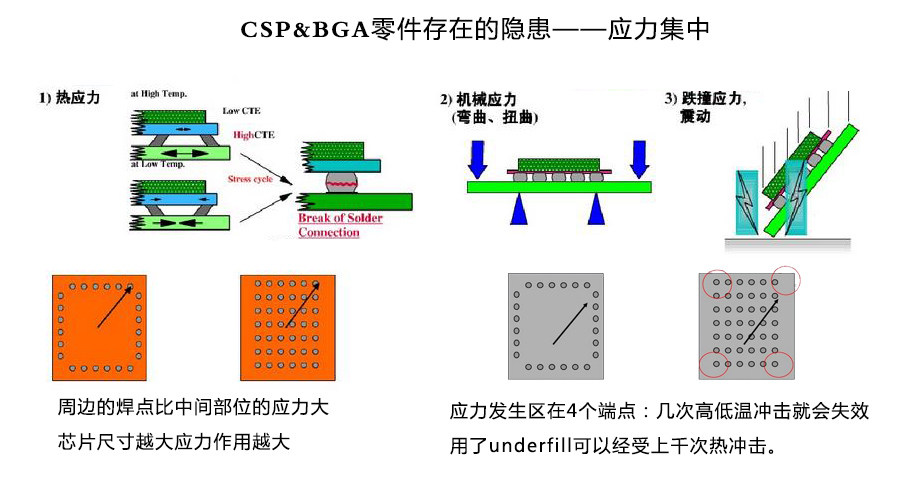

发表评论
◎欢迎参与讨论,请在这里发表您的看法、交流您的观点。